详情描述
非接触式厚度测量,可以测量背面研磨减薄和刻蚀后的薄晶圆,也可测量粘附在蓝膜或者其他载体上的有图形或凸起的晶圆,可应用于堆叠芯片和微机电系统。
优势:
FSM413回波探头传感器使用红外(IR)干涉测量技术,可以直接和测量从厚到薄的晶圆衬底厚度变化和总体厚度变化。配置单探头系统,可以测量一些对红外线透明的材料,例如Si, GaAs, InP, SiC, 玻璃,石英和一些聚合物,还可以测量常规有图形、有胶带、凸起或者键合在载体上晶圆的衬底厚度。配置双探头系统时,还提供晶圆整体厚度测量(包括衬底厚度和在光不能穿透的情况下的图形高度厚度)。选配功能可以测量沟槽深度和通孔深度(包括微机电中的高深宽比的沟槽和通孔)。另外微机电应用中薄膜厚度测量和凸块高度测量也可以选配。
基于FSM Echoprobe红外线干涉测量技术,提供非接触式芯片厚度和深度测量方法。
Echoprobe技术利用红外光束探测晶圆。
Echoprobe可用于测量多晶硅、蓝宝石、其它复合物半导体,例如GaAs, InP, GaP, GaN 等。
对晶圆图形衬底切割面进行直接测量。
行业应用:
主要应用在研磨芯片厚度控制、芯片后段封装、TSV(硅通孔技术)、(MEMS)微机电系统、 侧壁角度测量等。
针对LED行业, 可用作检测蓝宝石或碳化硅片厚度及TTV
其它应用:
· 沟槽深度测量
· 表面粗糙度测量
· 薄膜厚度测量
· 环氧厚度测量


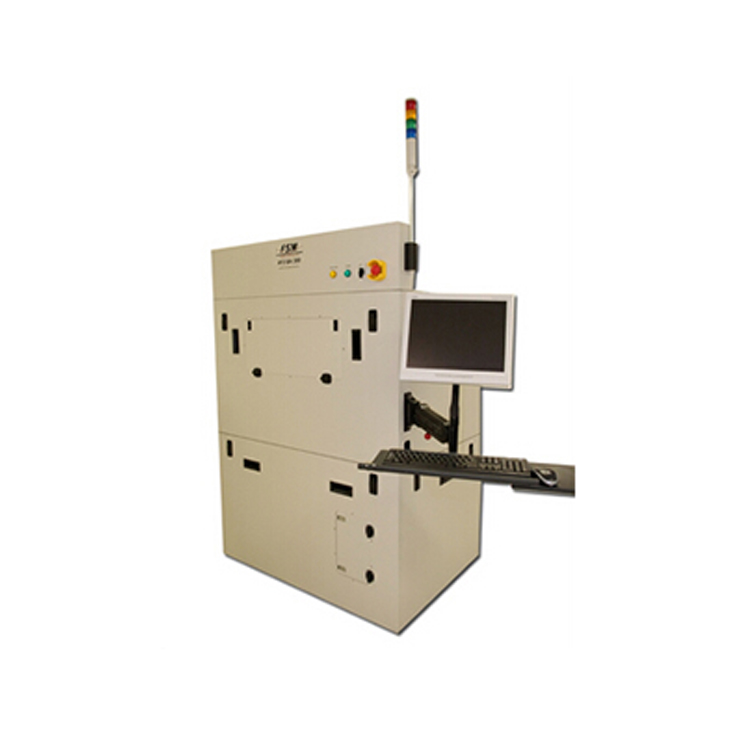
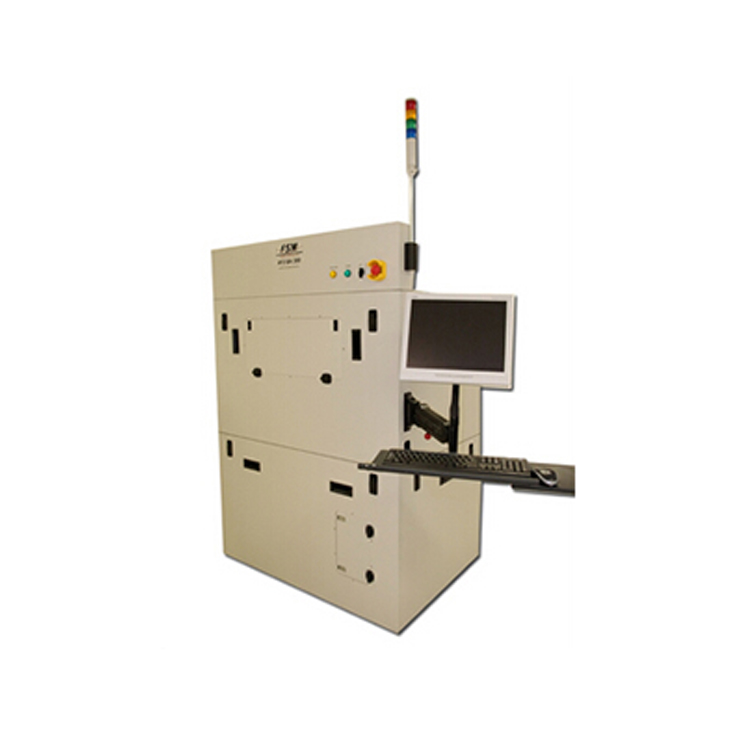
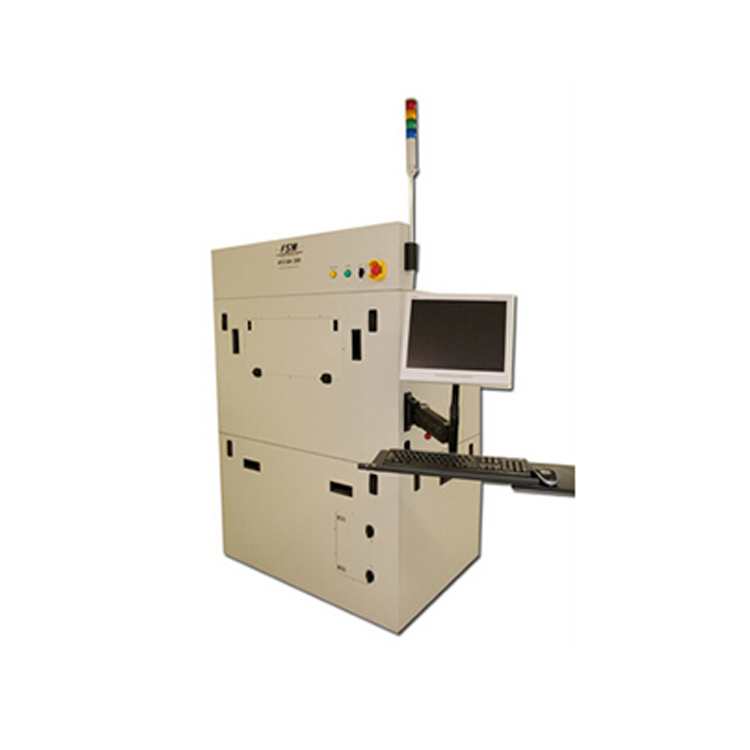















 冀公网安备13010402003046号
冀公网安备13010402003046号